Rastertunnelmikroskopie und -spektroskopie
Nahordnung in ternären III-V-Nanodrähten
Die Stabilisierung der Ordnung anstelle des Zufalls in legierten Halbleitermaterialien ist ein wirksames Mittel zur Veränderung ihrer physikalischen Eigenschaften. Wir haben Rastertunnel- und Transmissionselektronenmikroskopie eingesetzt, um die Existenz einer bisher unerkannten Ordnung in ternären III-V-Materialien aufzudecken.
Die Lazarevicit-Kurzstreckenordnung, die in der Schale von InAs1-xSbx-Nanodrähten zu finden ist, wird durch die starke Sb-Sb-Abstoßung entlang der <110>-Atomketten während ihres Einbaus auf nicht rekonstruierten {110}-Seitenwänden angetrieben. Ihre spontane Bildung unter Gruppe-III-reichen Wachstumsbedingungen bietet die Aussicht, die begrenzten Klassen von geordneten Strukturen, die in III-V-Halbleiterlegierungen auftreten, zu erweitern.

M. Schnedler, I. Lefebvre, T. Xu, V. Portz, G. Patriarche, J. P. Nys, S. R. Plissard, P. Caroff, M. Berthe, H. Eisele, R. E. Dunin-Borkowski, Ph. Ebert, and B. Grandidier: Lazarevicite-type short-range ordering in ternary III-V nanowires, Phys. Rev. B 94 (2016) 195306.
Quantitative Beschreibung der photoinduzierten Rastertunnelspektroskopie und ihre Anwendung auf die GaAs(110)-Oberfläche
Wir haben eine quantitative Beschreibung der photoinduzierten Rastertunnelspektroskopie entwickelt und auf photoinduzierte Spektren angewandt, die auf p-dotierten unpolaren GaAs(110)-Oberflächen gemessen wurden. Unter Beleuchtung zeigen die experimentellen Spektren einen Anstieg des Tunnelstroms nur bei negativen Probenspannungen.
Um die experimentellen Daten quantitativ zu analysieren, werden die Potential- und Ladungsträgerverteilungen des photoinduzierten Spitze-Vakuum-Halbleiter-Systems durch Lösung der Poisson- sowie der Loch- und Elektronen-Kontinuitätsgleichungen mit einem Finite-Differenzen-Algorithmus berechnet.

Auf dieser Grundlage werden die verschiedenen Beiträge zum Tunnelstrom mit Hilfe einer Erweiterung des Modells von Feenstra und Stroscio um die lichtangeregten Ladungsträgerkonzentrationen berechnet.
Die beste Anpassung der berechneten Tunnelströme an die experimentellen Daten ergibt sich für eine durch die Spitze induzierte Bandverbiegung, die durch die teilweise Besetzung des C3-Oberflächenzustands durch lichtangeregte Elektronen begrenzt ist.
Der Tunnelstrom bei negativen Spannungen setzt sich dann aus einem Valenzbandbeitrag und einem photoinduzierten Tunnelstrom von angeregten Elektronen im Leitungsband zusammen. Die hier entwickelte quantitative Beschreibung des Tunnelstroms ist allgemein anwendbar und bietet eine solide Grundlage für die quantitative Interpretation der photoinduzierten Rastertunnelspektroskopie.
M. Schnedler, V. Portz, P. H. Weidlich, R. E. Dunin-Borkowski, and Ph. Ebert: Quantitative description of photoexcited scanning tunneling spectroscopy and its application to the GaAs(110) surface, Phys. Rev. B 91 (2015) 235305.
Bedeutung der Quantenkorrektur für die quantitative Simulation von photoinduzierten Rastertunnelspektren von Halbleiteroberflächen
Die photoinduzierte Rastertunnelspektroskopie ist eine vielversprechende Technik für die Bestimmung von Ladungsträgerkonzentrationen, Oberflächenphotospannungen und Potenzialen von Halbleitern mit atomarer Ortsauflösung. Die Extraktion der gewünschten Größen erfordert jedoch die Berechnung des elektrostatischen Potenzials, das durch die Nähe der Spitze und den Tunnelstrom induziert wird. Diese Berechnung basiert auf einer genauen Lösung der Poisson- sowie der Kontinuitätsgleichungen für das System Spitze-Vakuum-Halbleiter. Zu diesem Zweck werden die Ladungsträgerstromdichten durch klassische Drift- und Diffusionsgleichungen modelliert.
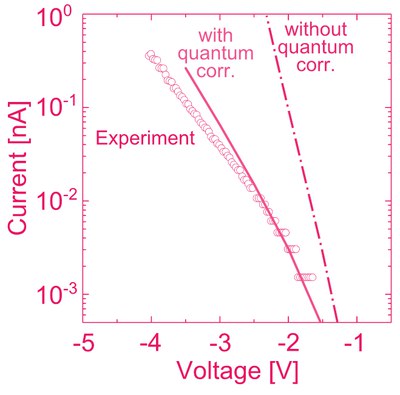
Für kleine Spitzenradien und hochdotierte Materialien überschätzt das Drift- und Diffusionstransportmodell die Ladungsträgerkonzentration eines Halbleiters in der Nähe der Oberfläche jedoch erheblich, was eine Quantifizierung der physikalischen Eigenschaften unmöglich macht. Wir wenden eine Quantenkorrektur auf das Drift- und Diffusionsmodell an, um der so genannten Quantenkompressibilität Rechnung zu tragen, d. h. der verringerten Kompressibilität des Trägergases aufgrund des Pauli-Prinzips im Bereich der spitzeninduzierten Bandverbiegung. Wir vergleichen Ladungsträgerkonzentrationen, Potenziale und Tunnelströme, die mit und ohne Quantenkorrektur für GaN(1010)- und GaAs(110)-Oberflächen abgeleitet wurden, um ihre Notwendigkeit zu demonstrieren.
M. Schnedler, R. E. Dunin-Borkowski, and Ph. Ebert: Importance of quantum correction for the quantitative simulation of photoexcited scanning tunneling spectra of semiconductor surfaces, Phys. Rev. B 93 (2016) 195444.
Untersuchung von Defektzuständen in polykristallinem GaN, das auf Si(111) aufgewachsen ist, mittels laserangeregter Rastertunnelspektroskopie mit Sub-Bandlücke
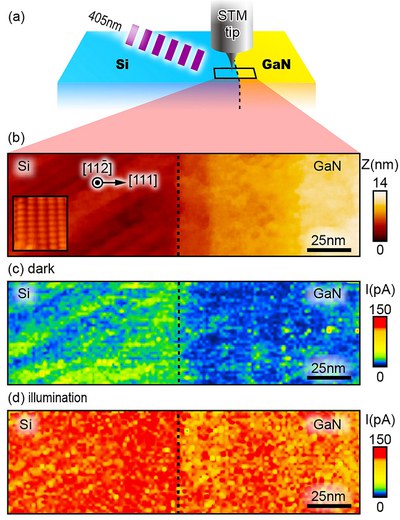
Die laserangeregte Sub-Bandlücken-Rastertunnelmikroskopie und -spektroskopie hat ein großes Potenzial, um das Vorhandensein von Defektzuständen in Halbleitern zu untersuchen. Die Charakterisierungsmethode wird an GaN-Schichten illustriert, die auf Si(111)-Substraten ohne absichtliche Pufferschichten gewachsen sind.
Laut hochauflösender Transmissionselektronenmikroskopie und Kathodolumineszenzspektroskopie bestehen die GaN-Schichten aus nanoskaligen Wurtzit- und Zinkblende-Kristalliten.
F.-M. Hsiao, M. Schnedler, V. Portz, Y.-C. Huang, B.-C. Huang, M.-C. Shih, C.-W. Chang, L.-W. Tu, H. Eisele, R. E. Dunin-Borkowski, Ph. Ebert, and Y.-P. Chiu: Probing defect states in polycrystalline GaN grown on Si(111) by sub-bandgap laser-excited scanning tunneling spectroscopy, J. Appl. Phys. 121 (2017) 015701.
Intrinsic electronic properties of high-quality wurtzite InN
Recent reports suggested that InN is a highly unusual III-V semiconductor, whose behavior fundamentally differs from that of others. We therefore analyzed its intrinsic electronic properties on the highest available quality InN layers, demonstrating the absence of electron accumulation at the (1010) cleavage surface and in the bulk.
The bulk electron density is governed solely by dopants. Hence, we conclude that InN acts similarly to the other III-V semiconductors and previously reported intriguing effects are related to low crystallinity, surface decomposition, nonstoichiometry, and/or In-adlayers.
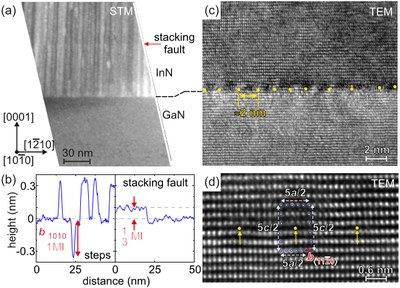
H. Eisele, J. Schuppang, M. Schnedler, M. Duchamp, C. Nenstiel, V. Portz, T. Kure, M. Bugler, A. Lenz, M. Dahne, A. Hoffmann, S. Gwo, S. Choi, J. S. Speck, R. E. Dunin-Borkowski, and Ph. Ebert: Intrinsic electronic properties of high-quality wurtzite InN, Phys. Rev. B 94 (2016) 245201.
Strain and compositional fluctuations in Al0.81In0.19N/GaN heterostructures
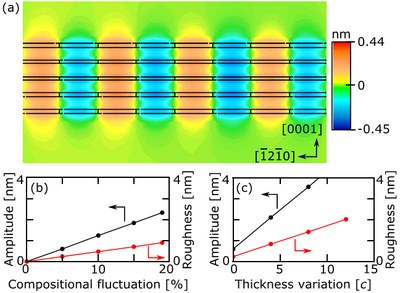
The strain and compositional fluctuations of nearly lattice-matched Al0.81In0.19N/GaN heterostructures are investigated by cross-sectional scanning tunneling microscopy and selected area electron diffraction measurements in scanning electron transmission microscopy.
The presence of strain induces height modulations governed by different roughness components at the cleavage surfaces. The surface height modulations are compatible with a relaxation of alternately compressive and tensile strained domains, indicating compositional fluctuations. Changes of the a lattice constant are traced to interface misfit edge dislocations. The dislocations induce steps increasing the roughness within the Al0.81In0.19N layers.
V. Portz, M. Schnedler, M. Duchamp, F.-M. Hsiao, H. Eisele, J.-F. Carlin, R. Butté, N. Grandjean, R. E. DuninBorkowski, and Ph. Ebert: Strain and compositional fluctuations in Al0.81In0.19N/GaN heterostructures, Appl. Phys. Lett. 109 (2016) 132102.
Fermi-level pinning and intrinsic surface states of Al1-xInxN(1010) surfaces
The electronic structure of Al1-xInxN(1010) surfaces is investigated by cross-sectional scanning tunneling spectroscopy and density functional theory calculations. The surface exhibits empty Al and/or In-derived dangling bond states, which are calculated to be within the fundamental bulk band gap for In compositions smaller than 60%.

The energy of the lowest empty In-derived surface state is extracted from the tunnel spectra for lattice-matched Al1-xInxN with In compositions of x = 0.19 and x = 0.20 to be EC − 1.82 ± 0.41 and EC − 1.80 ± 0.56 eV, respectively, in good agreement with the calculated energies. Under growth conditions, the Fermi level is hence pinned (unpinned) for In compositions smaller (larger) than 60%. The analysis of the tunnel spectra suggests an electron affinity of ~3.5 eV for nonpolar lattice-matched Al1-xInxN cleavage surfaces, which is large compared to linearly interpolated values of polar AlN and InN (0001) surfaces.
V. Portz, M. Schnedler, L. Lymperakis, J. Neugebauer, H. Eisele, J.-F. Carlin, R. Butté, N. Grandjean, R. E. Dunin-Borkowski, and Ph. Ebert: Fermi-level pinning and intrinsic surface states of Al1-xInxN(1010) surfaces, Appl. Phys. Lett. 110 (2017) 022104.
Polarity-dependent pinning of a surface state
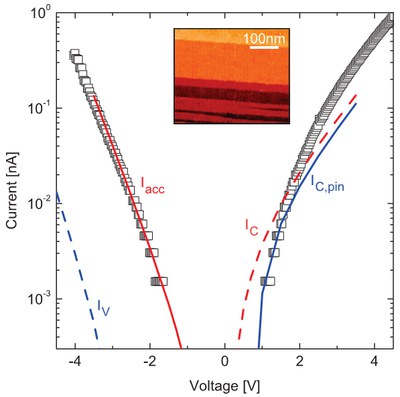
We illustrate a polarity-dependent Fermi level pinning at semiconductor surfaces with chargeable surface states within the fundamental band gap.
Scanning tunneling spectroscopy of the GaN(1010) surface shows that the intrinsic surface state within the band gap pins the Fermi energy only at positive voltages, but not at negative ones. This polarity dependence is attributed to arise from limited electron transfer from the conduction band to the surface state due to quantum mechanically prohibited direct transitions.
Thus, a chargeable intrinsic surface state in the band gap may not pin the Fermi level or only at one polarity, depending on the band to surface state transition rates.
M. Schnedler, V. Portz, H. Eisele, R. E. Dunin-Borkowski, and Ph. Ebert: Polarity-dependent pinning of a surface state, Phys. Rev. B 91 (2015) 205309.

Contact:
Dr. Philipp Ebert
Phone: +49 2461 61-5023
E-Mail: p.ebert@fz-juelich.de
